 來源:壹芯微 發布日期
2019-11-04 瀏覽:-
來源:壹芯微 發布日期
2019-11-04 瀏覽:-絕緣柵雙極晶體管(IGBT)
基礎知識
絕緣柵雙極晶體管(Insulated-gate Bipolar Transistor——IGBT)
GTR和MOSFET復合,結合二者的優點
1986年投入市場后,取代了GTR和一部分MOSFET的市場,
中小功率電力電子設備的主導器件
繼續提高電壓和電流容量,以期再取代GTO的地位
1. IGBT的結構和工作原理
三端器件:柵極G、集電極C和發射極E
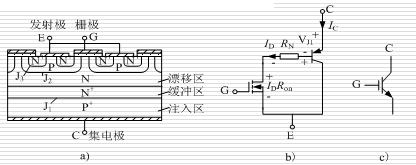
IGBT的結構、簡化等效電路和電氣圖形符號
a) 內部結構斷面示意圖b) 簡化等效電路c) 電氣圖形符號
(1)IGBT的結構
如圖所示,N溝道MOSFET與GTR組合——N溝道IGBT(N-IGBT)
IGBT比P-MOSFET多一層P+注入區,形成了一個大面積的P+N結J1
使IGBT導通時由P+注入區向N基區發射少子,從而對漂移
區電導率進行調制,使得IGBT具有很強的通流能力簡化等效電路表明,IGBT是GTR與MOSFET組成的達林頓結構,一個由MOSFET驅動的厚基區PNP晶體管
RN為晶體管基區內的調制電阻
(2)IGBT的工作原理
驅動原理與電力MOSFET基本相同,場控器件,通斷由柵射極電壓UGE決定
導通:
UGE大于開啟電壓UGE(th)時,MOSFET內形成溝道,為晶體管提供基極電流,IGBT導通
導通壓降:電導調制效應使電阻RN減小,使通態壓降小
關斷:
柵射極間施加反壓或不加信號時,MOSFET內的溝道消失,晶體管的基極電流被切斷,IGBT關斷
2. IGBT的靜態工作特性
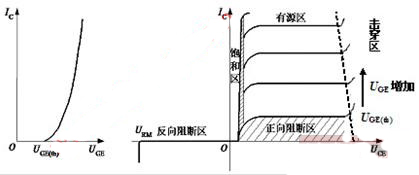
IGBT的轉移特性和輸出特性
a) 轉移特性 b) 輸出特性
(1)轉移特性:
IC與UGE間的關系,與MOSFET轉移特性類似。
開啟電壓UGE(th)——IGBT能實現電導調制而導通的最低柵射
電壓UGE(th)隨溫度升高而略有下降,在
+25?C時,UGE(th)的值一般為2~6V
(2)輸出特性(伏安特性):
以UGE為參考變量時,IC與UCE間的關系
分為四個區域:正向阻斷區、有源區、飽和區和擊穿區。
UCE<0時,IGBT為反向阻斷工作狀態
3.IGBT的動態特性
IGBT的開關過程

(1)IGBT的開通過程
與MOSFET的相似,因為開通過程中IGBT在大部分時間作為MOSFET運行
開通延遲時間td(on) ——從UGE上升至其幅值10%的時刻,到iC上升至10% ICM
電流上升時間tr ——iC從10%ICM上升至90%ICM所需時間
開通時間ton——開通延遲時間與電流上升時間之和
UCE的下降過程分為tfv1和tfv2兩段。
tfv1——IGBT中MOSFET單獨工作的電壓下降過程;
tfv2——MOSFET和PNP晶體管同時工作的電壓下降過程
(2)IGBT的關斷過程
關斷延遲時間td(off) ——從UGE后沿下降到其幅值90%的時刻
起,到iC下降至 90%ICM
電流下降時間——iC從90%ICM下降至10%ICM
關斷時間toff——關斷延遲時間與電流下降之和
電流下降時間又可分為tfi1和tfi2兩段。
tfi1——IGBT內部的MOSFET的關斷過程,iC下降較快;
tfi2——IGBT內部的PNP晶體管的關斷過程,iC下降較慢
IGBT中雙極型PNP晶體管的存在,雖然帶來了電導調制效應
的好處,但也引入了少子儲存現象,因而IGBT的開關速度低
于電力MOSFET
4. IGBT的主要參數
除了前面介紹的td(on)、tr、td(off)、tf、UGE(th)之外,還包括:
1)最大集射極間電壓:
包括柵射極短路時最大集射極間直流電壓UCES;柵射極開路時
最大集射極間直流電壓UCEO;柵射極反偏壓時最大集射極間直
流電壓UCEX。通常,由內部PNP晶體管擊穿
電壓確定,與GTR不同,三者差別較小,有。
2)最大集電極電流:包括額定直流電流IC和1ms脈寬最大電流ICP
3) 最大集電極功耗PCM :正常工作溫度下允許的最大功耗
4)最大柵極電壓
柵射極之間的電壓由柵極氧化膜厚度和特性所決定,一般應限制在20V以內,其最佳值一般取15V左右。
5. IGBT的特性和參數特點
(1)開關速度高,開關損耗小。在電壓1000V以上時,開關損耗只有GTR的1/10,與電力MOSFET相當
(2)相同電壓和電流定額時,安全工作區比GTR大,且具有耐脈沖電流沖擊能力
(3)通態壓降比VDMOSFET低,特別是在電流較大的區域
(4)輸入阻抗高,輸入特性與MOSFET類似
(5)與MOSFET和GTR相比,耐壓和通流能力還可以進一步提高,同 時保持開關頻率高的特點
6. IGBT的擎住效應和安全工作區

IGBT的結構、簡化等效電路和電氣圖形符號
a) 內部結構斷面示意圖b) 簡化等效電路c) 電氣圖形符號
(1) IGBT的安全工作區
正偏安全工作區(FBSOA)——最大集電極電流、最大集射極間電壓和最大集電極功耗確定
反向偏置安全工作區(RBSOA)——最大集電極電流、最大集射極間電壓和最大允許電壓上升率duCE/dt確定
(2) IGBT的擎住效應
寄生晶閘管——由一個N-PN+晶體管和作為主開關器件的P+N-P晶體管組成
擎住效應或自鎖效應:
NPN晶體管基極與發射極之間存在體區短路電阻,P形體區的橫向空穴電流會在該電阻上產生壓降,相當于對J3結施加正偏壓,一旦J3開通,柵極就會失去對集電極電流的控制作用,電流失控
動態擎住效應比靜態擎住效應所允許的集電極電流小擎住效應曾限制IGBT電流容量提高,20世紀90年代中后期
開始逐漸解決
IGBT往往與反并聯的快速二極管封裝在一起,制成模塊,成為逆導器件
注:電導調制效應
當PN結上流過的正向電流較小時,低摻雜N區的歐姆電阻較高,當PN結上流過較大正向電流時,注入并積累在低摻雜N區的少子空穴濃度將很大,為了維持半導體電中性條件,其多子濃度也相應大幅度增加,從而使其電阻率明顯下降,也就是電導率大幅增加,這就是電導調制效應。
壹芯微科技針對二三極管,MOS管作出了良好的性能測試,應用各大領域,如果您有遇到什么需要幫助解決的,可以點擊右邊的工程師,或者點擊銷售經理給您精準的報價以及產品介紹
工廠地址:安徽省六安市金寨產業園區
深圳辦事處地址:深圳市福田區寶華大廈A1428
中山辦事處地址:中山市古鎮長安燈飾配件城C棟11卡
杭州辦事處:杭州市西湖區文三西路118號杭州電子商務大廈6層B座
電話:13534146615
企業QQ:2881579535

深圳市壹芯微科技有限公司 版權所有 | 備案號:粵ICP備2020121154號